Параметры MOSFET транзисторов


Технологические возможности и успехи в разработке мощных полевых транзисторов привели к тому, что в настоящее время не составляет особого труда приобрести их за приемлемую цену.
В связи с этим возрос интерес радиолюбителей к применению таких MOSFET транзисторов в своих электронных самоделках и проектах.
Стоит отметить тот факт, что MOSFET’ы существенно отличаются от своих биполярных собратьев, как по параметрам, так и своему устройству.
Пришло время ближе познакомиться с устройством и параметрами мощных MOSFET транзисторов, чтобы в случае необходимости более осознанно подобрать аналог для конкретного экземпляра, а также иметь возможность понимать суть тех или иных величин, указанных в даташите.
Что такое HEXFET транзистор?
В семействе полевых транзисторов есть отдельная группа мощных полупроводниковых приборов называемых HEXFET. Их принцип работы основан на весьма оригинальном техническом решении. Их структура представляет собой несколько тысяч МОП ячеек включенных параллельно.
Ячеистые структуры образуют шестиугольник. Из-за шестиугольной или по-другому гексагональной структуры данный тип мощных МОП-транзисторов и называют HEXFET. Первые три буквы этой аббревиатуры взяты от английского слова hexagonal – «гексагональный».
Под многократным увеличением кристалл мощного HEXFET транзистора выглядит вот так.

Как видим, он имеет шестиугольную структуру.
Получается, что мощный MOSFET, по сути представляет собой эдакую супер-микросхему, в которой объединены тысячи отдельных простейших полевых транзисторов. В совокупности они создают один мощный транзистор, который может пропускать через себя большой ток и при этом практически не оказывать значительного сопротивления.
Благодаря особой структуре и технологии изготовления HEXFET, сопротивление их канала RDS(on) удалось заметно снизить. Это позволило решить проблему коммутации токов в несколько десятков ампер при напряжении до 1000 вольт.
Вот только небольшая область применения мощных HEXFET транзисторов:
- Схемы коммутации электропитания.
- Зарядные устройства.
- Системы управления электродвигателями.
- Усилители низкой частоты.
- Ключи для управления мощными нагрузками.
Несмотря на то, что мосфеты, изготовленные по технологии HEXFET (параллельных каналов) обладают сравнительно небольшим сопротивлением открытого канала, сфера применения их ограничена, и они применяются в основном в высокочастотных сильноточных схемах. В высоковольтной силовой электронике предпочтение порой отдают схемам на основе IGBT.

Транзисторы HEXFET марки IRLZ44ZS
Изображение MOSFET транзистора на принципиальной электрической схеме (N-канальный МОП).
Как и биполярные транзисторы, полевые структуры могут быть прямой проводимости или обратной. То есть с P-каналом или N-каналом. Выводы обозначаются следующим образом:
- D-drain (сток);
- S-source (исток);
- G-gate (затвор).
О том, как обозначаются полевые транзисторы разных типов на принципиальных схемах можно узнать на этой странице.
Основные параметры полевых транзисторов.
Вся совокупность параметров MOSFET может потребоваться только разработчикам сложной электронной аппаратуры и в даташите (справочном листе), как правило, не указывается. Достаточно знать основные параметры:
- VDSS (Drain-to-Source Voltage) – напряжение между стоком и истоком. Это, как правило, напряжение питания вашей схемы. При подборе транзистора всегда необходимо помнить о 20% запасе.
- ID (Continuous Drain Current) – ток стока или непрерывный ток стока. Всегда указывается при постоянной величине напряжения затвор-исток (например, VGS=10V). В даташите, как правило, указывается максимально возможный ток.
- RDS(on) (Static Drain-to-Source On-Resistance) – сопротивление сток-исток открытого канала. При увеличении температуры кристалла сопротивление открытого канала увеличивается. Это легко увидеть на графике, взятом из даташита одного из мощных HEXFET транзисторов. Чем меньше сопротивление открытого канала (RDS(on)), тем лучше мосфет. Он меньше греется.

- PD (Power Dissipation) – мощность транзистора в ваттах. По-иному этот параметр ещё называют мощностью рассеяния. В даташите на конкретное изделие величина данного параметра указывается для определённой температуры кристалла.
- VGS (Gate-to-Source Voltage) – напряжение насыщения затвор-исток. Это напряжение, при превышении которого увеличения тока через канал не происходит. По сути, это максимальное напряжение между затвором и истоком.
- VGS(th) (Gate Threshold Voltage) – пороговое напряжение включения транзистора. Это напряжение, при котором происходит открытие проводящего канала и он начинает пропускать ток между выводами истока и стока. Если между выводами затвора и истока приложить напряжение меньше VGS(th), то транзистор будет закрыт.

На графике видно, как уменьшается пороговое напряжение VGS(th) при увеличении температуры кристалла транзистора. При температуре 175°C оно составляет около 1 вольта, а при температуре 0°C около 2,4 вольт. Поэтому в даташите, как правило, указывается минимальное (min.) и максимальное (max.) пороговое напряжение.

Рассмотрим основные параметры мощного полевого HEXFET-транзистора на примере IRLZ44ZS фирмы International Rectifier. Несмотря на впечатляющие характеристики, он имеет малогабаритный корпус D 2 PAK для поверхностного монтажа. Глянем в datasheet и оценим параметры этого изделия.
- Предельное напряжение сток-исток (VDSS): 55 Вольт.
- Максимальный ток стока (ID): 51 Ампер.
- Предельное напряжение затвор-исток (VGS): 16 Вольт.
- Сопротивление сток-исток открытого канала (RDS(on)): 13,5 мОм.
- Максимальная мощность (PD): 80 Ватт.
Сопротивление открытого канала IRLZ44ZS составляет всего лишь 13,5 миллиОм (0,0135 Ом)!
Взглянем на «кусочек» из таблицы, где указаны максимальные параметры.

Хорошо видно, как при неизменном напряжении на затворе, но при повышении температуры уменьшается ток (с 51A (при t=25°C) до 36А (при t=100°C)). Мощность при температуре корпуса 25°C равна 80 Ваттам. Так же указаны некоторые параметры в импульсном режиме.
Транзисторы MOSFET обладают большим быстродействием, но у них есть один существенный недостаток – большая ёмкость затвора. В документах входная ёмкость затвора обозначается как Ciss (Input Capacitance).
На что влияет ёмкость затвора? Она в большой степени влияет на определённые свойства полевых транзисторов. Поскольку входная ёмкость достаточно велика, и может достигать десятков пикофарад, применение полевых транзисторов в цепях высокой частоты ограничивается.
В схемах переключения время заряда паразитной входной ёмкости транзистора влияет на скорость его срабатывания.
Важные особенности MOSFET транзисторов.
Очень важно при работе с полевыми транзисторами, особенно с изолированным затвором, помнить, что они “смертельно” боятся статического электричества. Впаивать их в схему можно только предварительно закоротив выводы между собой тонкой проволокой.
При хранении все выводы МОП-транзистора лучше закоротить с помощью обычной алюминиевой фольги. Это уменьшит риск пробоя затвора статическим электричеством. При монтаже его на печатную плату лучше использовать паяльную станцию, а не обычный электрический паяльник.
Дело в том, что обычный электрический паяльник не имеет защиты от статического электричества и не «развязан» от электросети через трансформатор. На его медном жале всегда присутствуют электромагнитные «наводки» из электросети.
Любой всплеск напряжения в электросети может повредить паяемый элемент. Поэтому, впаивая полевой транзистор в схему электрическим паяльником, мы рискуем повредить MOSFET-транзистор.
Параметры полевых транзисторов: что написано в даташите
Силовые инверторы, да и многие другие электронные устройства, редко обходятся сегодня без применения мощных MOSFET (полевых) или IGBT-транзисторов. Это касается как высокочастотных преобразователей типа сварочных инверторов, частотно-регулируемых электроприводов, блоков питания, светодиодных драйверов, так и разнообразных проектов-самоделок, схем коих полным полно в интернете.
Параметры выпускаемых ныне силовых полупроводников позволяют коммутировать токи в десятки и сотни ампер при напряжении до 1000 вольт.
Выбор этих компонентов на современном рынке электроники довольно широк, и подобрать полевой транзистор с требуемыми параметрами отнюдь не является проблемой сегодня, поскольку каждый уважающий себя производитель сопровождает конкретную модель полевого транзистора технической документацией, которую всегда можно найти как на официальном сайте производителя, так и у официальных дилеров.
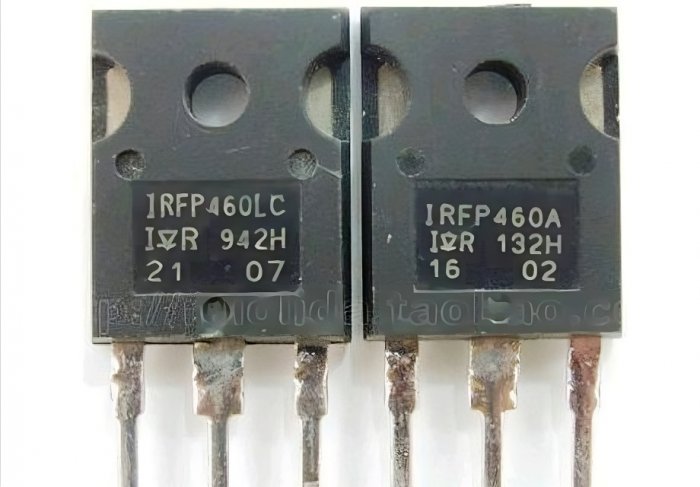
Прежде чем приступить к проектированию того или иного устройства, с применением названных силовых компонентов, всегда нужно точно знать, с чем имеешь дело, особенно когда выбираешь конкретный полевой транзистор. Для этого и обращаются к datasheet’ам.
Datasheet представляет собой официальный документ от производителя электронных компонентов, в котором приводятся описание, параметры, характеристики изделия, типовые схемы и т.д.
Давайте же посмотрим, что за параметры указывает производитель в даташите, что они обозначают и для чего нужны.
Рассмотрим на примере даташита на полевой транзистор IRFP460LC. Это довольно популярный силовой транзистор, изготовленный по технологии HEXFET.
HEXFET подразумевает такую структуру кристалла, когда в одном кристалле организованы тысячи параллельно-включенных МОП-транзисторных ячеек гексагональной формы. Это решение позволило значительно снизить сопротивление открытого канала Rds(on) и сделало возможным коммутацию больших токов. Однако, перейдем к обзору параметров, указанных непосредственно в даташите на IRFP460LC от International Rectifier (IR).

В самом начале документа дано схематичное изображение транзистора, приведены обозначения его электродов: G-gate (затвор), D-drain (сток), S-source (исток), а также указаны его главные параметры и перечислены отличительные качества.
В данном случае мы видим, что этот полевой N-канальный транзистор рассчитан на максимальное напряжение 500 В, сопротивление его открытого канала составляет 0,27 Ом, а предельный ток равен 20 А.
Пониженный заряд затвора позволяет использовать данный компонент в высокочастотных схемах при невысоких затратах энергии на управление переключением.
Ниже приведена таблица (рис. 1) предельно допустимых значений различных параметров в различных режимах.
- Id @ Tc = 25°C; Continuous Drain Current Vgs @ 10V — максимальный продолжительный, непрерывный ток стока, при температуре корпуса полевого транзистора в 25°C, составляет 20 А. При напряжении затвор-исток 10 В.
- Id @ Tc = 100°C; Continuous Drain Current Vgs @ 10V — максимальный продолжительный, непрерывный ток стока, при температуре корпуса полевого транзистора в 100°C, составляет 12 А. При напряжении затвор-исток 10 В.
- Idm @ Tc = 25°C; Pulsed Drain Current — максимальный импульсный, кратковременный ток стока, при температуре корпуса полевого транзистора в 25°C, составляет 80 А. При условии соблюдения приемлемой температуры перехода. На рисунке 11 (Fig 11) дается пояснение относительно соответствующих соотношений.
- Pd @ Tc = 25°C Power Dissipation — максимальная рассеиваемая корпусом транзистора мощность, при температуре корпуса в 25°C, составляет 280 Вт.
- Linear Derating Factor — с повышением температуры корпуса на каждый 1°C, рассеиваемая мощность возрастает еще на 2,2 Вт.
- Vgs Gate-to-Source Voltage — максимальное напряжение затвор-исток не должно быть выше +30 В или ниже -30 В.
- Eas Single Pulse Avalanche Energy — максимальная энергия единичного импульса на стоке составляет 960 мДж. Пояснение дается на рисунке 12 (Fig 12).
- Iar Avalanche Current — максимальный прерываемый ток составляет 20 А.
- Ear Repetitive Avalanche Energy — максимальная энергия повторяющихся импульсов на стоке не должна превышать 28 мДж (для каждого импульса).
- dv/dt Peak Diode Recovery dv/dt — предельная скорость нарастания напряжения на стоке равна 3,5 В/нс.
- Tj, Tstg Operating Junction and Storage Temperature Range – безопасный температурный диапазон от -55°C до +150°C.
- Soldering Temperature, for 10 seconds — допустимая при пайке максимальная температура составляет 300°C, причем на расстоянии минимум 1,6мм от корпуса.
- Mounting torque, 6-32 or M3 screw — максимальный момент при креплении корпуса не должен превышать 1,1 Нм.
Далее следует таблица температурных сопротивлений (рис 2.). Эти параметры будут необходимы при подборе подходящего радиатора.
- Rjc Junction-to-Case (кристалл-корпус) 0.45 °C/Вт.
- Rcs Case-to-Sink, Flat, Greased Surface (корпус-радиатор) 0.24 °C/Вт.
- Rja Junction-to-Ambient (кристалл-окружающая среда) зависит от радиатора и внешних условий.
Следующая таблица содержит все необходимые электрические характеристики полевого транзистора при температуре кристалла 25°C (см. рис. 3).
- V(br)dss Drain-to-Source Breakdown Voltage — напряжение сток-исток, при котором наступает пробой равно 500 В.
- V(br)dss/Tj Breakdown Voltage Temp.Coefficient — температурный коэффициент, напряжения пробоя, в данном случае 0,59 В/°C.
- Rds(on) Static Drain-to-Source On-Resistance — сопротивление сток-исток открытого канала при температуре 25°C, в данном случае, составляет 0,27 Ом. Оно зависит от температуры, но об этом позже.
- Vgs(th) Gate Threshold Voltage — пороговое напряжение включения транзистора. Если напряжение затвор-исток будет меньше (в данном случае 2 — 4 В), то транзистор будет оставаться закрытым.
- gfs Forward Transconductance — Крутизна передаточной характеристики, равна отношению изменения тока стока к изменению напряжения на затворе. В данном случае измерена при напряжении сток-исток 50 В и при токе стока 20 А. Измеряется в Ампер/Вольт или Сименсах.
- Idss Drain-to-Source Leakage Current — ток утечки стока, он зависит от напряжения сток-исток и от температуры. Измеряется микроамперами.
- Igss Gate-to-Source Forward Leakage и Gate-to-Source Reverse Leakage — ток утечки затвора. Измеряется наноамперами.
- Qg Total Gate Charge — заряд, который нужно сообщить затвору для открытия транзистора.
- Qgs Gate-to-Source Charge — заряд емкости затвор-исток.
- Qgd Gate-to-Drain («Miller») Charge — соответствующий заряд затвор-сток (емкости Миллера)
В данном случае эти параметры измерены при напряжении сток-исток, равном 400 В и при токе стока 20 А. На рисунке 6 дано пояснение относительно связи величины напряжения затвор-исток и полного заряда затвора Qg Total Gate Charge, а на рисунках 13 a и b приведены схема и график этих измерений.
- td(on) Turn-On Delay Time — время открытия транзистора.
- tr Rise Time — время нарастания импульса открытия (передний фронт).
- td(off) Turn-Off Delay Time — время закрытия транзистора.
- tf Fall Time — время спада импульса (закрытие транзистора, задний фронт).
В данном случае измерения проводились при напряжении питания 250 В, при токе стока 20 А, при сопротивлении в цепи затвора 4,3 Ом, и сопротивлении в цепи стока 20 Ом. Схема и графики приведены на рисунках 10 a и b.
- Ld Internal Drain Inductance — индуктивность стока.
- Ls Internal Source Inductance — индуктивность истока.
Данные параметры зависит от исполнения корпуса транзистора. Они важны при проектировании драйвера, поскольку напрямую связаны с временными параметрами ключа, особенно это актуально при разработке высокочастотных схем.
- Ciss Input Capacitance — входная емкость, образованная условными паразитными конденсаторами затвор-исток и затвор-сток.
- Coss Output Capacitance — выходная емкость, образованная условными паразитными конденсаторами затвор-исток и исток-сток.
- Crss Reverse Transfer Capacitance — емкость затвор-сток (емкость Миллера).
Данные измерения проводились на частоте 1 МГц, при напряжении сток-исток 25 В. На рисунке 5 показана зависимость данных параметров от напряжения сток-исток.
Следующая таблица (см. рис. 4) описывает характеристики интегрированного внутреннего диода полевого транзистора, условно находящегося между истоком и стоком.
- Is Continuous Source Current (Body Diode) — максимальный непрерывный длительный ток диода.
- Ism Pulsed Source Current (Body Diode) — максимально допустимый импульсный ток через диод.
- Vsd Diode Forward Voltage — прямое падение напряжения на диоде при 25°C и токе стока 20 А, когда на затворе 0 В.
- trr Reverse Recovery Time — время обратного восстановления диода.
- Qrr Reverse Recovery Charge — заряд восстановления диода.
- ton Forward Turn-On Time — время открытия диода обусловлено главным образом индуктивностями стока и истока.
Дальше в даташите приводятся графики зависимости приведенных параметров от температуры, тока, напряжения и между собой (рис 5).
Приведены пределы тока стока, в зависимости от напряжения сток-исток и напряжения затвор-исток при длительности импульса 20 мкс. Первый рисунок — для температуры 25°C, второй — для 150°C. Очевидно влияние температуры на управляемость открытием канала.
На рисунке 6 графически представлена передаточная характеристика данного полевого транзистора. Очевидно, чем ближе напряжение затвор-исток к 10 В, тем лучше открывается транзистор. Влияние температуры также просматривается здесь довольно отчетливо.
На рисунке 7 приведена зависимость сопротивления открытого канала при токе стока в 20 А от температуры. Очевидно, с ростом температуры увеличивается и сопротивление канала.
На рисунке 8 показана зависимость величин паразитных емкостей от приложенного напряжения сток-исток. Можно видеть, что уже после перехода напряжением сток-исток порога в 20 В, емкости меняются не значительно.
На рисунке 9 приведена зависимость прямого падения напряжения на внутреннем диоде от величины тока стока и от температуры. На рисунке 8 показана область безопасной работы транзистора в зависимости от длительности времени открытого состояния, величины тока стока и напряжения сток-исток.
На рисунке 11 показана зависимость максимального тока стока от температуры корпуса.
На рисунках а и b представлены схема измерений и график, показывающий временную диаграмму открытия транзистора в процессе нарастания напряжения на затворе и в процессе разряда емкости затвора до нуля.
На рисунке 12 изображены графики зависимости средней термической реакции транзистора (кристалл-корпус) на длительность импульса, в зависимости от коэффициента заполнения.
На рисунках a и b показаны схема измерений и график разрушительного действия на транзистор импульса при размыкании индуктивности.
На рисунке 14 показана зависимость максимально допустимой энергии импульса от величины прерываемого тока и температуры.
На рисунках а и b показаны график и схема измерений заряда затвора.
На рисунке 16 показана схема измерений параметров и график типичных переходных процессов во внутреннем диоде транзистора.
На последнем рисунке изображен корпус транзистора IRFP460LC, его размеры, расстояние между выводами, их нумерация: 1-затвор, 2-сток, 3-исток.
Так, прочитав даташит, каждый разработчик сможет подобрать подходящий силовой или не очень, полевой или IGBT-транзистор для проектируемого либо ремонтируемого силового преобразователя, будь то сварочный инвертор, частотник или любой другой силовой импульсный преобразователь.
Зная параметры полевого транзистора, можно грамотно разработать драйвер, настроить контроллер, провести тепловые расчеты, и подобрать подходящий радиатор без необходимости ставить лишнее.
Телеграмм канал для тех, кто каждый день хочет узнавать новое и интересное: Школа для электрика
Если Вам понравилась эта статья, поделитесь ссылкой на неё в социальных сетях. Это сильно поможет развитию нашего сайта!
Не пропустите обновления, подпишитесь на наши соцсети:
2.11. Пороговое напряжение мдп транзистора
Пороговым напряжением МДП транзистора называется такое напряжение на затворе, при котором концентрация подвижных носителей, индуцированных в инверсном канале под затвором, равна концентрации примеси в подложке. Принимается, что проводимость в индуцированном канале появляется после того, как потенциал на поверхности достигнет потенциала инверсии. Для n-канального транзистора на p-подложке с концентрацией акцепторов потенциал инверсии
потенциал инверсии и (2.9) примет вид
и (2.9) примет вид

.
Здесь  – заряд подвижных носителей в канале, а
– заряд подвижных носителей в канале, а – заряд акцепторов:
– заряд акцепторов:
где  – ширина ОПЗ под инверсным каналом,
– ширина ОПЗ под инверсным каналом, – диэлектрическая проницаемость кремния в отличие от
– диэлектрическая проницаемость кремния в отличие от для
для .
.

Обычно пренебрегают зависимостью заряда поверхностных состояний от поверхностного потенциала, считая, что этот заряд уже учтен в напряжении плоских зон. Используя (17) с , можно получить

.

Пороговое напряжение

(2.11)

Линейная зависимость описывается емкостью подложки
 , где
, где  — ширина ОПЗ в подложке
— ширина ОПЗ в подложке

(2.12)

— линейный коэффициент влияния подложки.
2.12. Вольт-амперная характеристика мдп транзистора

Выражение для дрейфового тока стока может быть получено интегрированием исходного равенства
 в пределах от
в пределах от  на истоке при
на истоке при до
до на стоке при
на стоке при – длина канала,
– длина канала, – ширина канала. В таком выражении
– ширина канала. В таком выражении – часть поверхностного потенциала, создаваемая стоковым напряжением. Стоковый потенциал создает тянущее поле для электронов и одновременно уменьшает заряд электронов вдоль канала тем, что увеличивает потенциал канала и поэтому уменьшает напряжение между затвором и каналом. Кроме этого, потенциал канала увеличивает заряд акцепторов под каналом.
– часть поверхностного потенциала, создаваемая стоковым напряжением. Стоковый потенциал создает тянущее поле для электронов и одновременно уменьшает заряд электронов вдоль канала тем, что увеличивает потенциал канала и поэтому уменьшает напряжение между затвором и каналом. Кроме этого, потенциал канала увеличивает заряд акцепторов под каналом.
 ,
,  .
.

Используя понятие линейного коэффициента влияния подложки , имеем

,

здесь определяется уже выражением (2.12). Интегрирование дает в крутой области

(2.13)

Граница крутой и пологой областей, когда вблизи стока

и в пологой области

, (2.14)

удельная крутизна

Подложка действует вполне аналогично затвору в полевом транзисторе с управляющим p-nпереходом. Обратное напряжение на переходе исток-подложкарасширяет ОПЗ под каналом и подзапирает канал, индуцированный полем основного, изолированного затвора.
На рис. 26 показаны типичные вольтамперные характеристики МОП транзистора в крутой и пологой областях.
2.13. Конструктивные разновидности мдп транзисторов
За сорокалетие развития технологии МДП схем конструкции и технология МДП транзисторов претерпели существенные изменения. Сформировались несколько самостоятельных научно-технических направлений разработки и применения МДП транзисторов. Среди них:
- Мощные транзисторы,
- Элементы сверхбольших интегральных схем,
- Элементы запоминающих устройств.
Некоторые конструктивно-технологические направления требуют хотя бы краткого обсуждения, поскольку они представляют общетехнический интерес.  Рис. 26.Типичные ВАХ МОП транзистора в крутой и пологой областях Параметры транзистора:
Рис. 26.Типичные ВАХ МОП транзистора в крутой и пологой областях Параметры транзистора:  = 0.1 мА/В 2 ,
= 0.1 мА/В 2 ,  = 0.7 В,
= 0.7 В, = 0.5 В,
= 0.5 В,  = 0.3.
= 0.3.
2.13.1. Мощные моп транзисторы
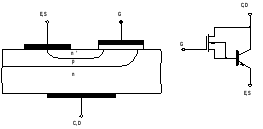
Мощные МОП транзисторы составляют отдельное направление силовой полупроводниковой электроники. На рис.27 представлена структура мощного вертикального IGBJтранзистора, который представляет собой объединение входного транзистора с изолированным затвором и выходного биполярного транзистора, ток истока входного транзистора подается в базу мощного выходного транзистора. Малая длина канала, большая крутизна и ток сочетаются с большим допустимым напряжением на коллекторе и стоке, т.к. область обеднения распространяется в слаболегированнуюn–область и большое напряжение на стоке не вызывает смыкания канала и лавинного пробоя. Рис. 27. Структура и эквивалентная схема IGBJ транзистора E, S — эмиттер BJ и исток IG транзистора; C, D — коллектор BJ и сток IG транзистора; G – затвор IG транзистора.
Что такое пороговое напряжение на затворе

MOSFET-транзистор, определение и типы
MOSFET-транзисторы – полевые транзисторы с изолированным затвором. Расшифровка аббревиатуры — Metal-Oxide-Semiconductor (металл – окисел – полупроводник) и Field-Effect-Transistors (транзистор, управляемый электрическим полем) Вообще класс полевых транзисторов включает полупроводниковые приборы, управляемые внутренним полем. Внутреннее поле создается напряжением, поэтому полевые транзисторы, в отличие от биполярных транзисторов управляются напряжением! Именно это свойство обеспечивает широкое применение полевых транзисторов.
Ключевыми преимуществами MOSFET-транзисторов являются:
— малая энергия на переключение транзисторы (фактически нужно только перезарядить емкость затвора);
— высокая скорость переключения;
— во включённом состоянии представляет собой омическое сопротивление.
MOSFET-транзисторы как и биполярные транзисторы имеют две основных типа структуры: n-канальные и p-канальные.
Не вдаваясь во внутренние подробности строения MOSFET транзисторов укажем основные отличия в принципе управления:
— n-канальный MOSFET-транзистор открывается положительной полярностью напряжения затвор-исток, и в открытом состоянии пропускает ток от стока к истоку;
— p-канальный MOSFET-транзистор открывается отрицательной полярностью напряжения затвор-исток, и в открытом состоянии пропускает ток от истока к стоку.
По той же причине, что и в биполярных транзисторах, n-канальные MOSFET-транзисторы шустрее p-канальных MOSFET-транзисторов.
Условные обозначения транзисторов n-канального и p-канального MOSFET-транзисторов представлены на рисунке MOSFET.1.
Особенности MOSFET-транзисторов. Реверсный диод в составе MOSFET-транзистора
MOSFET-транзистор в открытом состоянии фактически представляет собой сопротивление. То есть падение напряжения на транзисторе зависит только от его тока. Это очень важное отличие от биполярного транзистора и IGBT-транзистора, всегда имеющих некоторое падение напряжение в открытом состоянии.
В закрытом состоянии сопротивление MOSFET-транзистора составляет десятки-сотни МОм. В открытом – от единиц Ом до единиц миллиОм. Впрочем, сопротивление MOSFET-транзистора в открытом состоянии непостоянно – оно несколько увеличивается с ростом тока. Как правило, не более чем 20-25% при изменении тока от минимального значения до максимального.
Необходимо отметить, что из-за особенностей внутренней структуры MOSFET-транзистор имеет в своем составе паразитный обратный диод, включенный параллельно стоку-истоку, который иногда приводят в условном обозначении транзистора (рисунок MOSFET.2). Если быть до конца точным, то паразитный диод является следствием паразитного транзистора присутствующего в конструкции MOSFET-транзистора. При изготовлении база транзистора электрически соединяется с истоком и коллекторный переход выполняет роль обратного диода.
Падение напряжения на обратном диоде составляет 0,6-0,8 В, что меньше падения напряжения на обычном кремниевом p-n диоде (рисунок MOSFET.3). Именно по этой причине параллельное включение внешних обратных диодов бессмысленно. Ложку дегтя еще добавляет и то, что этот диод достаточно медленный, то есть достаточно долго (порядка 0,3-1 мкс) переходит в непроводящее состояние при смене полярности тока. Существуют схемотехнические способы обойти этот диод например путем последовательного включения в цепь стока диода Шоттки и «обходного» быстродействующего диода включаемого параллельно цепи транзистора и диода.
Достаточно подробно про внутреннюю структуру MOSFET-транзисторов изложено в [Энциклопедия устройств на полевых транзисторах. Дьяконов В.П.,Максимчк А.А.,Ремиев А.М.,Смердов В.Ю. СОЛОН-Р. 2002. 512 с.].
Применение MOSFET-транзисторов
Области использования MOSFET-транзисторов:
— в импульсных преобразователях и стабилизаторах;
— в генераторных устройствах;
— в усилительных каскадах (особенно в звуковых Hi-Fi усилителях);
— в твердотельных реле;
— в качестве элемента логических схем.
Основные преимущества MOSFET-транзисторов проявляются при их использовании в качестве ключевых элементов.
При всех преимуществах MOSFET-транзисторы достаточно «нежные» существа: боятся статического электричества, разрушаются при перегреве свыше 150 °С. Из этого следует то, что полевые транзисторы более критичны к перегреву при пайке по сравнению с биполярными, а также то, что с ними целесообразно работать при условии защиты от статического электричества.
Основные параметры MOSFET-транзистора
Ниже перечислены основные параметры MOSFET-транзистора данные на которые приводятся в справочных листках — datasheet-ах:
1. Максимальное напряжение сток-исток (Drain-Source Voltage) VDS – максимально допустимое напряжение между стоком и истоком транзистора.
2. Сопротивление сток-исток RDS – сопротивление между стоком и истоком в открытом состоянии. При заданном напряжении затвор-исток. И токе стока.
3. Максимальное напряжение затвор-исток (Gate-Source Voltage) VGS – максимальное управляющее напряжение затвор-исток. При превышении этого напряжения возможен пробой затворного диэлектрика и выход транзистора из строя.
4. Максимальный ток стока в непрерывном режиме (Continuous Drain Current) ID – максимальная величина постоянно протекающего тока стока в непрерывном режиме. Зависит от температуры корпуса транзистора и условий теплоотвода.
5. Максимальный импульсный ток стока (Pulsed Drain Current) IDM — максимальная величина импульсного тока стока. Зависит от коэффициента заполнения, условий теплоотвода. Принципиально ограничивается энергией рассеивания кристалла.
6. Энергия рассеивания кристалла (Single Pulse Avalanche Energy) EAS – максимальная энергия, которая может быть рассеяна на кристалле транзистора без его разрушения.
7. Максимальная рассеиваемая мощность (Maximum Power Dissipation) PD – максимальная тепловая мощность, которая может быть отведена от корпуса транзистора (при заданной температуре корпуса транзистора).
8. Диапазон рабочих температур — диапазон температур, в пределах которого допускается эксплуатация транзистора.
8. Тепловое сопротивление транзистор-воздух RthJA (Maximum Junction-to-Ambient) — максимальное тепловое сопротивление транзистор-воздух (при условии свободного конвективного теплообмена).
9. Тепловое сопротивление корпус транзистора – теплоотвод (Case-to-Sink, Flat, Greased Surface) RthCS — максимальное тепловое сопротивление перехода корпус транзистора – теплоотвод. При условии плоской блестящей поверхности теплоотвода.
10. Тепловое сопротивление корпус транзистора (Maximum Junction-to-Case (Drain) RthJC — максимальное тепловое сопротивление кристалл — корпус транзистора.
11. Пороговое напряжение затвор-исток (Gate-Source Threshold Voltage) VGS(th) — пороговое напряжение затвор-исток, при котором начинается переход транзистора в проводящее состояние.
12. Ток утечки стока (Zero Gate Voltage Drain Current) IDSS – ток стока выключенного транзистора (при нулевом напряжении затвор-исток). Значительно зависит от температуры.
13. Ток утечки затвора (Gate-Source Leakage) IGSS – ток через затвор при некотором (как правило максимальном) напряжении затвор-исток.
14. Входная емкость (Input Capacitance) Ciss – суммарная емкость затвор-исток и емкость затвор-сток (при некотором напряжении сток-исток).
15. Выходная емкость (Output Capacitance) Coss – суммарная емкость затвор-сток и емкость сток-исток.
16. Проходная емкость (Reverse Transfer Capacitance) Crss – емкость затвор-сток.
17. Общий заряд затвора (Total Gate Charge) Qg – суммарный заряд затвора, необходимый для перевода транзистора в проводящее состояние.
18. Заряд затвор-исток (Gate-Source Charge) Qgs – заряд емкости затвор-исток.
20. Заряд затвор-сток (Gate-Drain Charge) Qgd — заряд емкости затвор-сток.
21. Время задержки включения (Turn-On Delay Time) td(on) – время за которое транзистор накапливает заряд до напряжения на затворе, при котором транзистор начинает открываться.
22. Время роста тока через транзистор (Rise Time) – время, за которое происходит нарастание тока стока транзистора от 10% до 90%.
23. Время задержки выключения (Turn-Off Delay Time) td(off) – время за которое заряд затвора становится меньшим заряда включения, и транзистор начинает закрываться.
24. Время спада тока через транзистор (Fall Time) — время, за которое происходит спад тока стока транзистора от 10% до 90%.
25. Индуктивность вывода стока (Internal Drain Inductance) LD – паразитная индуктивность вывода стока транзистора.
26. Индуктивность вывода истока (Internal Source Inductance) LS – паразитная индуктивность вывода истока транзистора.
27. Постоянный прямой ток через обратный диод (Continuous Source-Drain Diode Current) IS – максимальное значение постоянно протекающего прямого тока через паразитный p-n диод.
28. Импульсный ток через обратный диод (Pulsed Diode Forward Current) ISM – максимальное значение постоянно протекающего прямого тока через паразитный p-n диод.
29. Падение напряжения на диоде (Body Diode Voltage) VSD – прямое падение напряжения на диоде. При заданных температуре и токе истока.
30. Время восстановления паразитного диода (Body Diode Reverse Recovery Time) trr — время восстановления обратной проводимости паразитного диода.
31. Заряд восстановления паразитного диода (Body Diode Reverse Recovery Charge) Qrr – заряд необходимый для восстановления обратной проводимости паразитного диода.
32. Время включения паразитного диода (Forward Turn-On Time) ton — время перехода диода в проводящее состояние. Обычно составляет пренебрежимо малую величину.
33. Паразитное сопротивление затвора (Gate resistance) RG – паразитное последовательное сопротивление затвора. Именно оно ограничивает скорость переключения при управляющем драйвере с большим выходным током.
Паразитные емкости MOSFET-транзистора
На рисунке MOSFET.4 представлены паразитные емкости MOSFET-транзистора. Их всего три – емкость «затвор-исток», «затвор–сток», «сток-исток». И три их производные – входная емкость (Input Capacitance), проходная емкость (Reverse Transfer Capacitance), выходная емкость (Output Capacitance).
Инерционность MOSFET-транзистора, определяющая времена включения и выключения лимитируется, прежде всего, паразитными емкостями транзистора.

В реальности паразитные емкости не являются постоянными величинами: их величина сильно зависит от напряжения между их «обкладками»: при малых значениях напряжения сток-исток ёмкости имеют значительную величину (например, на порядок превышающие численные значения, указанные в справочных листках) которые быстро уменьшается с ростом напряжения сток-исток (рисунок MOSFET.5). Поэтому все справочные значения емкости справедливы при определенном значении напряжения сток-исток.
Для мощных MOSFET-транзисторов на динамику включения-выключения влияет и паразитное сопротивление затвора.
Детально влияние емкостей на процесс коммутации MOSFET транзистора и проявление так называемого эффекта Миллера представлено в разделе «Управление MOSFET и IGBT транзисторами. Схемотехнические решения. Расчет».
Параллельное включение MOSFET-транзисторов
По причине того, что во включенном состоянии MOSFET-транзистор фактически представляет собой сопротивление, MOSFET-транзисторы легко объединяются параллельно. При этом пропорционально увеличиваются токовые и мощностные характеристики.
Для подавления возможных паразитных осцилляций целесообразно развязывать управляющие затворы через затворные резисторы (рисунок MOSFET.6).